
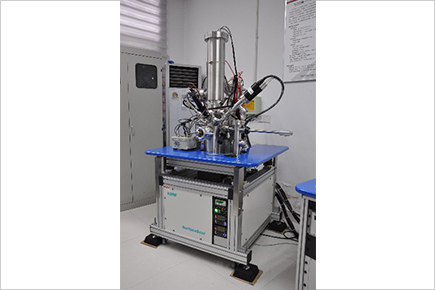
| 儀器名稱 | 飛行時間——二次離子質譜儀 |
| 規格型號 | SurfaceSeer-Ⅰ |
| 生產廠家 | 英國Kore |
| 儀器簡介 | 飛行時間——二次離子質譜儀(TOF-SIMS)采用質譜技術分析材料表面原子層以確定表面元素組成和分子結構。其工作原理是樣品表面被高能聚焦的一次離子轟擊時,一次離子注入被分析樣品,把動能傳遞給固體原子,通過層疊碰撞,引起中性粒子和帶正負電荷的二次離子發生濺射,再通過測量不同二次離子的飛行時間測量它們的質量/荷質比,對被轟擊的樣品的表面和內部元素分布特征進行分析。二次離子質譜可以分析包括氫在內的全部元素,并能給出同位素的信息、分析化合物組分和分子構成,靈敏度好、質量分辨率高、可測量的分子量范圍大,還可以進行微區成分成像和深度剖面分析。 |
| 性能指標 | 高分辨質譜: 靈敏度:靈敏度:10^9個原子/cm^2(上標) 可檢測質量范圍:1-3000 amu 質量分辨率:原子:1000 (FWHM);有機物:2000 (FWHM) 質量準確度:0.56 mamu 微區成像: SIMS化學成像,空間分辨率:0.2 μm 二次電子成像 深度剖面:深度分辨率:1.1 nm 一次離子源:AuGa液態金屬離子 離子束能量:25 keV 脈沖微區尺寸:0.2 μm(低電流),0.5 μm(高電流) 離子刻蝕槍:Cs+離子槍,離子束能量:0.5-5 keV 正、負離子SIMS模式一鍵切換 通氧,幫助提高正二次離子產額 低能脈沖電子槍(30eV),用于絕緣樣品分析 |
| 測試項目 | 固體表面全元素和1-3000有機物質譜分析,痕量元素/有機物定量,二次離子成像、痕量元素深度分布分析 |
| 樣品要求 | 薄樣品架:16.5×13.5 mm以內,厚度方向500μm以內厚樣品架:16.5×13.5 mm以內,厚度方向約1 mm4位置可變厚度樣品架:8×8 mm以內,厚度方向6 mm以內 |
| 設備負責人 | 設備負責人:汪雪 聯系電話: Email:wangxue@sinap.ac.cn |